- Главная
- Разное
- Бизнес и предпринимательство
- Образование
- Развлечения
- Государство
- Спорт
- Графика
- Культурология
- Еда и кулинария
- Лингвистика
- Религиоведение
- Черчение
- Физкультура
- ИЗО
- Психология
- Социология
- Английский язык
- Астрономия
- Алгебра
- Биология
- География
- Геометрия
- Детские презентации
- Информатика
- История
- Литература
- Маркетинг
- Математика
- Медицина
- Менеджмент
- Музыка
- МХК
- Немецкий язык
- ОБЖ
- Обществознание
- Окружающий мир
- Педагогика
- Русский язык
- Технология
- Физика
- Философия
- Химия
- Шаблоны, картинки для презентаций
- Экология
- Экономика
- Юриспруденция
Что такое findslide.org?
FindSlide.org - это сайт презентаций, докладов, шаблонов в формате PowerPoint.
Обратная связь
Email: Нажмите что бы посмотреть
Презентация на тему Влияние имплантации ионов фосфора на структурные изменения в поверхностных слоях монокристалла кремния
Содержание
- 2. Цель работыИсследование структурных изменений в приповерхностных слоях
- 3. Для реализации цели:Использовано методы рентгеновской топографии и
- 4. 1исходная2имплантацияОбразец кремния схематичноИсходная областьИонная имплантация:фосфор (Е=180кеВ, D=8·1014cм-2)
- 5. КОСОНЕСИММЕТРИЧНАЯ ДИФРАКЦИИ В ГЕОМЕТРИИ НА ОТРАЖЕНИЕИ
- 6. Топография монокристалов Siа) Lext=2,1мкмб) Lext=1,05мкмв) Lext=0,75мкмХ-лучевые топограмы монокристала Si:CuKα-излучение, входящая плоскость (111)1112221-исходная область;2-имплантированаяс17
- 7. Атомно-силовая микроскопия образца Siб)а)Объёмное изображение микрорельефа поверхности образца Siа) исходная областьб) имплантированая область18
- 8. Схема трехосного рентгеновского дифрактометра Високоразрешающий трехосный рентгеновский
- 9. Кривые дифракционного отражения монокристалла Si -800
- 10. Кривые дифракционного отражения монокристалла Si:сопоставление теоретической и
- 11. Скачать презентацию
- 12. Похожие презентации



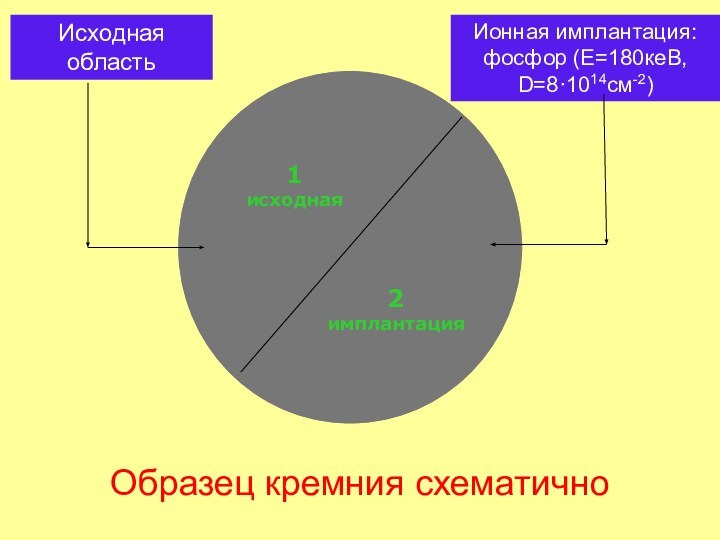



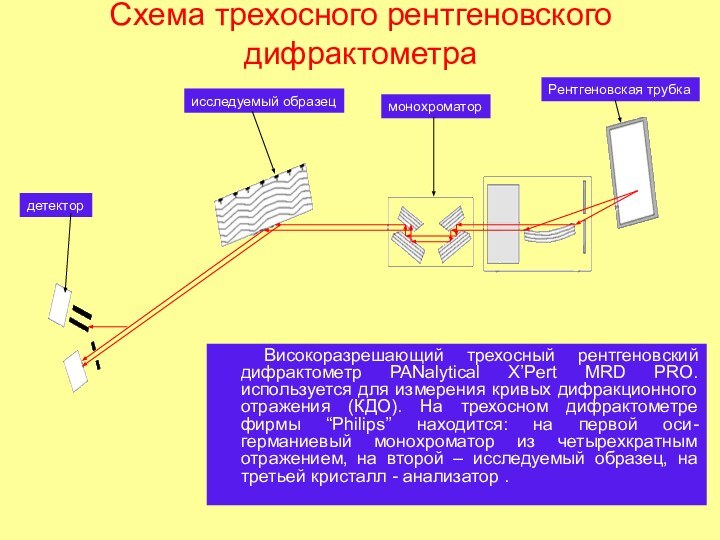



Слайд 2
Цель работы
Исследование структурных изменений в приповерхностных слоях монокристаллов
Si после имплантации ионов фосфора.
Е=180 кэВ, доза - D=81014 см-2
Слайд 3
Для реализации цели:
Использовано методы рентгеновской топографии и двухкристального
спектрометра;
Использовано численные методы решения системы дифференциальных уравнений, описывающие процессы
рассеяния рентгеновских лучей в искаженных кристаллах
Слайд 4
1
исходная
2
имплантация
Образец кремния схематично
Исходная область
Ионная имплантация:
фосфор (Е=180кеВ, D=8·1014cм-2)
Слайд 5
КОСОНЕСИММЕТРИЧНАЯ ДИФРАКЦИИ
В ГЕОМЕТРИИ НА ОТРАЖЕНИЕ
И –
источник рентг. излучения
Щ – щель
П – пленка
К – кристалл
Основное
условие:
Схема
эксперимента
Схематическое представление особенный значений азимутального угла поворота
при повороте кристалла вокруг
вектора дифракции
0 < 0 cos tgBctg дифракция Лауэ;
00 cos
0 0 кр дифракція Брэгга
и эффект ПВО
Слайд 6
Топография монокристалов Si
а) Lext=2,1мкм
б) Lext=1,05мкм
в) Lext=0,75мкм
Х-лучевые топограмы монокристала
Si:
CuKα-излучение,
входящая плоскость (111)
1
1
1
2
2
2
1-исходная область;
2-имплантированаяс
17
Слайд 7
Атомно-силовая микроскопия образца Si
б)
а)
Объёмное изображение микрорельефа поверхности образца
Si
а) исходная область
б) имплантированая область
18
Слайд 8
Схема трехосного рентгеновского дифрактометра
Високоразрешающий трехосный рентгеновский дифрактометр
PANalytical X’Pert MRD PRO. используется для измерения кривых дифракционного
отражения (КДО). На трехосном дифрактометре фирмы “Philips” находится: на первой оси- германиевый монохроматор из четырехкратным отражением, на второй – исследуемый образец, на третьей кристалл - анализатор .Рентгеновская трубка
монохроматор
исследуемый образец
детектор
Слайд 9
Кривые дифракционного отражения монокристалла Si
-800
-600 -400 -200 0
200 400 600 800 ∆θlg(I/I0)
1E-3
0.1
1
2
отражение (111),
CuКa- излучение
1 – исходная область,
2 – имплантированная область
Слайд 10
Кривые дифракционного отражения монокристалла Si:
сопоставление теоретической и экспериментальных
кривых
-600
-400 -200 0 200 400 600 ∆θlg(I/I0)
отражение (333),
CuКα - излучение
1 – экспериментальная кривая,
2 – теоретически рассчитанная кривая.
1
2
0 500 1000 1500 2000 2500 Z, нм
2
1
0
-1
-2
∆d/d *10-3
Профиль деформации в приповерхностных
слоях кристалла, имплантированного ионами фосфора
0 2000 4000 6000 8000 Z,E
6
5
4
3
2
n*10-19
1
Распределение имплантированных ионов фосфора
в кристалле кремния, полученное с помощью
программного пакета SRIM-2003





























